НАЦИОНАЛЬНЫЙ ИССЛЕДОВАТЕЛЬСКИЙ ЯДЕРНЫЙ УНИВЕРСИТЕТ
МОСКОВСКИЙ ИНЖЕНЕРНО-ФИЗИЧЕСКИЙ ИНСТИТУТ
(НИЯУ МИФИ) Факультет: Автоматика и Электроника
Кафедра: Микро- и наноэлектроника
Курс: Компьютерный Практикум ЛИТОГРАФИЯ 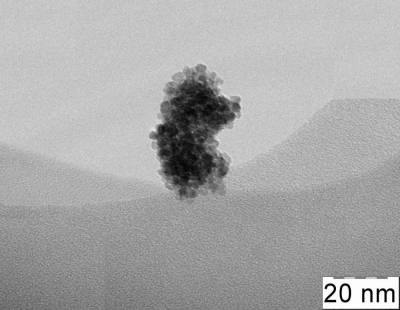
Выполнил: Лебедев Н. В.
Группа: А4-09
Преподаватель: доцент Лапшинский В. А.
Дата: 20.03.2010 Содержание
1. Введение
2. Основные термины
3. Литография
4. История развития литографии
5. Проблема литографии
6. Используемая литература Введение
В данной работе рассматривается технология литографии и история ее развития. Также рассматриваются основные технологические операции для получения кислотостойкой маски и проблемы современной литографии. Основные термины
1. Нанолитография – способ массового изготовления интегральных схем с использованием в литографическом оборудовании источника экстремального ультрафиолетового излучения.
2. EUV-диапазон – экстремальный ультрафиолетовый диапазон длин.
Литография1
Сегодня микроэлектроника является одним из основных направлений научно-технического развития наиболее развитых мировых держав. А уровень развития и объемы производства ее ос¬новных изделий - интегральных схем (ИС) во многом определяет оборонный, экономический и культурный потенциалы страны.
Основной идеей любого из видов литографии является получение кислотостойкой двумерной защитной маски на поверхности какого-либо подслоя. Если эта маска будет обладать необходимой конфигурацией, то ее можно использовать как шаблон для
локального воздействия на подслой в ходе следующей технологической операции.
Все основные технологические операции можно разделить на несколько больших групп:
- подготовка поверхностей для предстоящей обработки;
- нанесение слоев (окисление, осаждение, распыление);
- изменение рельефа слоев (травление, планаризация);
- изменение электрофизических свойств слоев (ионная имплантация, диффузия);
- создание маски для последующей локальной обработки (ФЛ);
- вскрытие контактных площадок в слое пассивации готовых микросхем;
- функционального тестирования микросхем на пластине с целью определения их соответствия требуемым рабочим характеристикам (годности) и отбраковки негодных схем;
- сборки микросхем на кристалле в корпус;
- функционального тестирования корпусированной ИМС.
Все технологические операции обработки пластины, кроме ФЛ, воздействуют на всю поверхность пластины одновременно. Но для воспроизведения топологии ИС необходимо воздействовать на предыдущий слой или кремниевую подложку селективно.
ФЛ служит инструментом для формирования планарной топологической структуры ИС, и от ее разрешающей способности во многом зависят предельные размеры элементов получаемых изделий. История развития литографии
Наиболее быстрыми темпами литография стала развиваться с 1970-х годов.
В 1992 году был преодолен барьер в 0.35 мкм, для этого использовалась i-линия ртутной лампы высокого давления с длиной волны 365 нм. Дальнейшее уменьшение критических размеров на пластине происходило за счет сокращения длины волны источника излучения. В 1996-98 г. в качестве источников излучения начали использовать излучение эксимерных лазеров на KrF и ArF, что позволило сократить длину волны излучения до 248 нм и 193 нм соответственно. Благодаря переходу на источники излучения, действующие в спектре глубокого и экстремального ультрафиолета (УФ), с длиной волны 248 нм (эксимерные KrF-лазеры) и193 нм (эксимерные ArF-лазеры), стало возможным получать 45-нанометровые линии, а это уже четверть длины волны. При использовании иммерсионных жидкостей этот показатель может достигнуть значения в одну шестую λ.
С момента появления литографии в основном ее совершенствование продвигалось по пути уменьшения длины волны экспонирующего излучения. В современной ситуации это невозможно, поэтому прибегают к другим методам совершенствования процесса фотолитографии. При дальнейшем уменьшении размеров элементов мы сталкиваемся с целым рядом проблем, которые свидетельствуют о наступлении предела возможностей современной фотолитографии. Проблемы литографии
Актуальные проблемы фотолитографии:
1. Увеличение сопротивления областей транзистора, уменьшить которое легированием уже не представляется возможным;
2. Увеличение паразитных емкостей и токов утечки при приближении элементов друг к другу;
3. Ярко выраженные эффекты дифракции и аберрации на зеркалах установок, несмотря на то, что они обработаны со средними квадратичными отклонениями не более 0,1–0,3 нм, и совершенством поверхности не хуже, чем λ/20, что соответствует 0,5 нм.;
4. Проблемы создания источников излучения. До сих пор не удалось создать источника излучения с длиной волны 157 нм на эксимерных лазерах. Альтернативой эксимерным лазерам служит построение источника излучения с длиной волны 13.5 нм на EVL лазере. Для генерации излучения с длинной волны 13.5 нм сегодня используются двухкомпонентные лазер – плазменные источники,
состоящие из мощного YAG лазера (0.1 – 1 ТВт, 1000 нм, 100 Гц) и мишени.
Проблема создания EUV2 лазера в настоящее время не решена. В качестве мишени можно использовать металлические мишени или мишени, представляющие собой сверхзвуковые струи инертных газов. Удар лазера по мишени вызывает в последней интенсивные процессы разрушения – абляции, с переходом вещества мишени в плазменное состояние, которая и является ярким источником EUV излучения.
 рис. 1. Плазменное облако – источник EUV рис. 1. Плазменное облако – источник EUV
Металлические мишени характеризуются высоким коэффициентом отдачи, но и высоким коэффициентом «мусорообразования»: при воздействии лазера на мишени происходит локальное разрушение мишени с образованием кратера, который развивается со скоростью порядка 150 м/с в результате чего частицы мишени попадают на первое зеркало,загрязняя его.
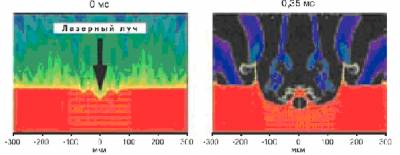  рис. 2. Динамика зарождения кратера на поверхности мишени рис. 2. Динамика зарождения кратера на поверхности мишени
5. Излучение с длиной волны порядка 13 нм активно поглощается практически всеми материалами и атмосферой в частности, следовательно, возникает проблема создания зеркал для проекционной фотолитографии;
6. ИВследствие активного поглощения атмосферой необходима организация вакуумированых технологических циклов, что сопряжено с массой трудностей реализации.
Демпфирование и амортизация вибраций, создаваемых вакуумными насосами и приводами предметных столов, является очередной конструкторской задачей, при требуемых точностных параметрах совмещения ФШ и пластин;
7. Существенно возрастает сложность технологической коррекции, учета эффектов «близости», рельефа подстилающей поверхности и неоднородном отражении от нее, вследствие оптических явлений и неоднородных коэффициентов отражения;
8. Экспоненциально растет информационная емкость технологических файлов, их объем достигает сотен Гб. Используемая литература
1. Жабрев В.А., Основы субмикронной технологии : Учеб. пособие / В. А. Жабрев, В. И. Марголин, В. А. Мошников ; М-во образования РФ. С.-Петерб. гос. электротехн. ун-т "ЛЭТИ", СПб.: Изд-во СПбГЭТУ "ЛЭТИ", 2001.
2. Лыньков Л.М., Субмикронная литография / Л. М. Лыньков, С. Л. Прищепа; М-во образования Беларусь. Белорус. гос. ун-т информатики и радиоэлектроники. Науч.-исслед., Минск, 1999.
3. Баканов Г.Ф., Фотолитография, М-во образования РФ,СПб.: Изд-во СПбГЭТУ «ЛЭТИ», 2002. |